

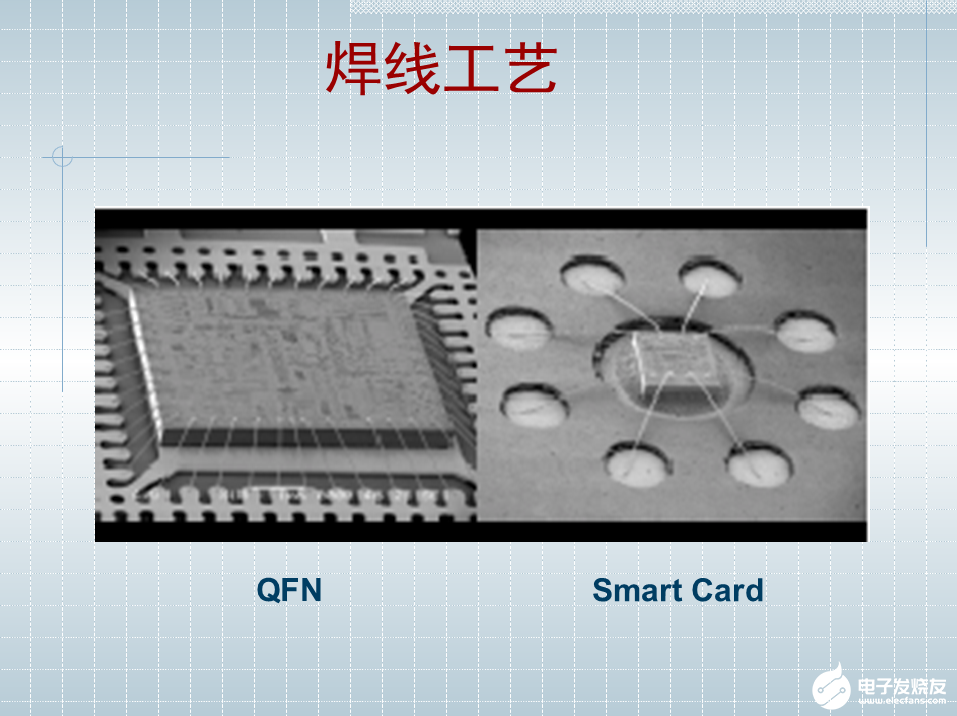





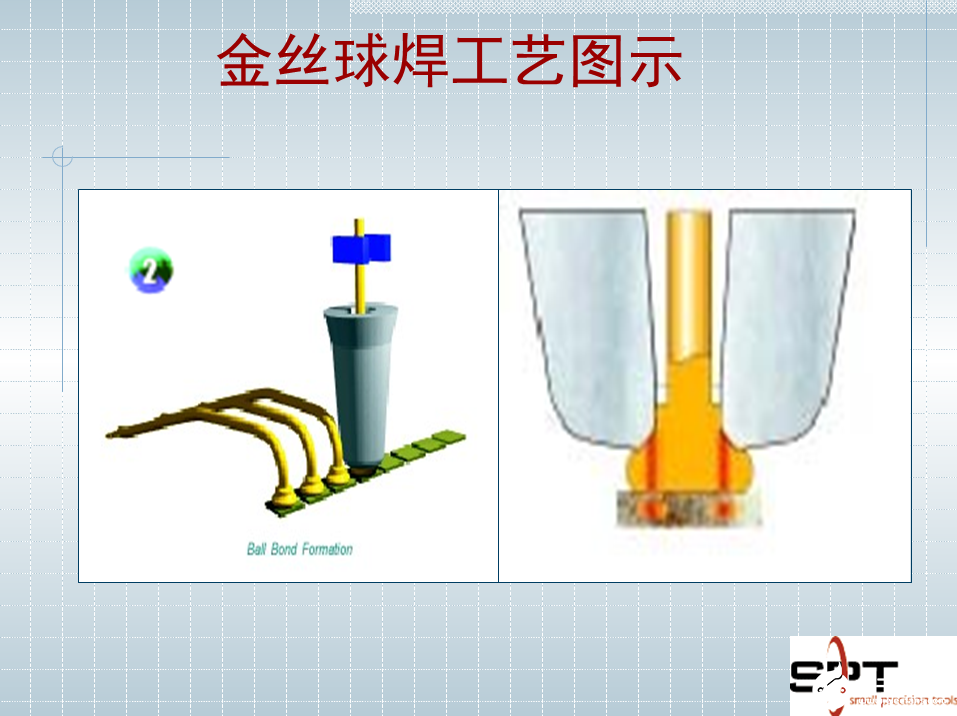



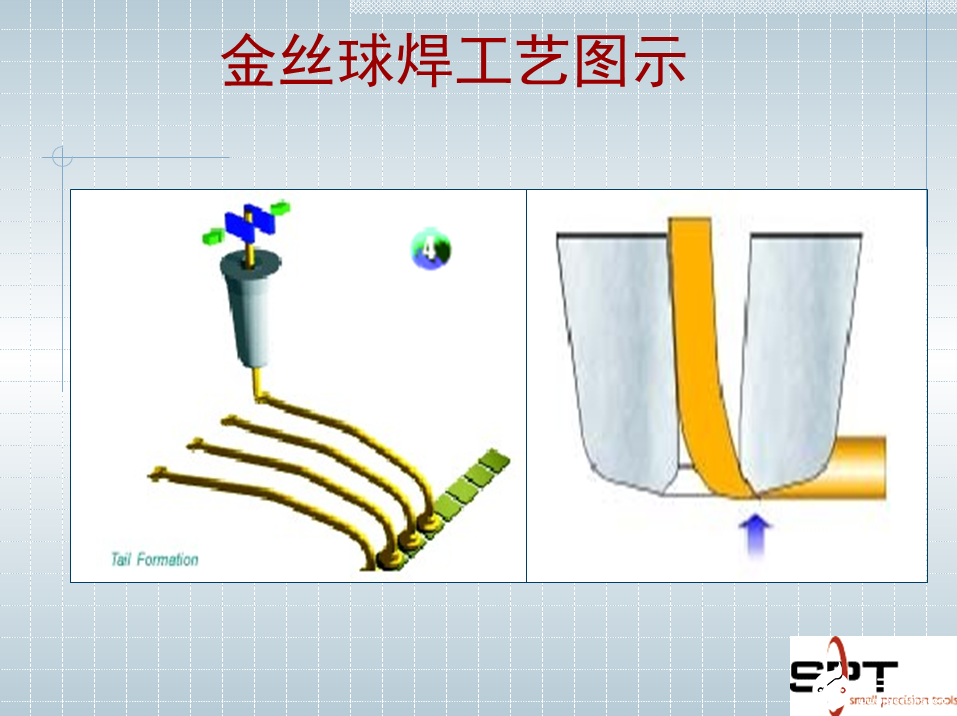




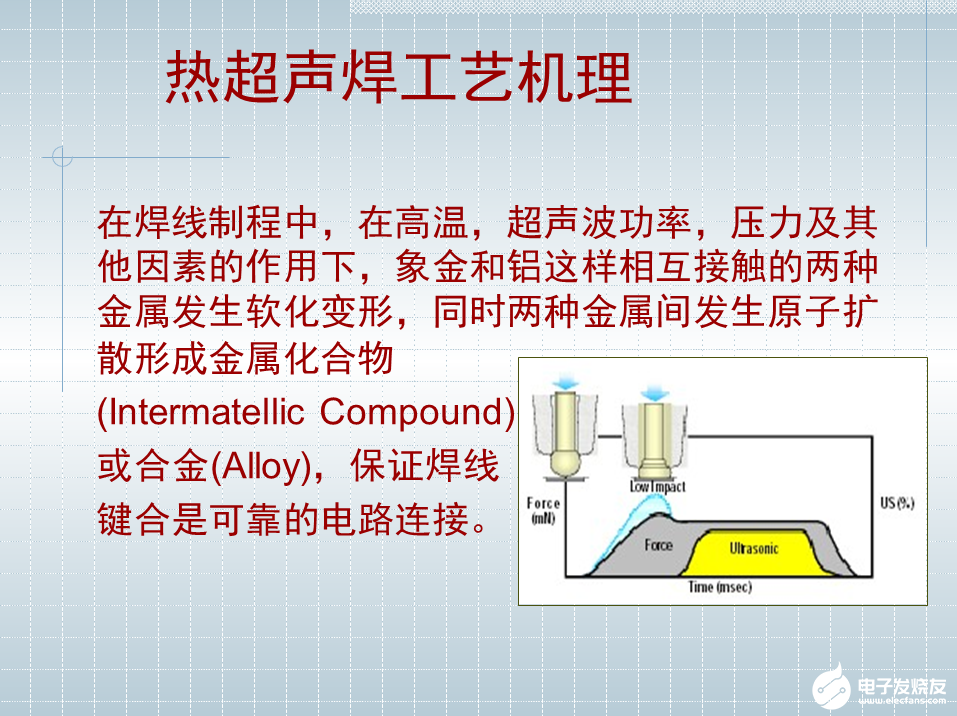
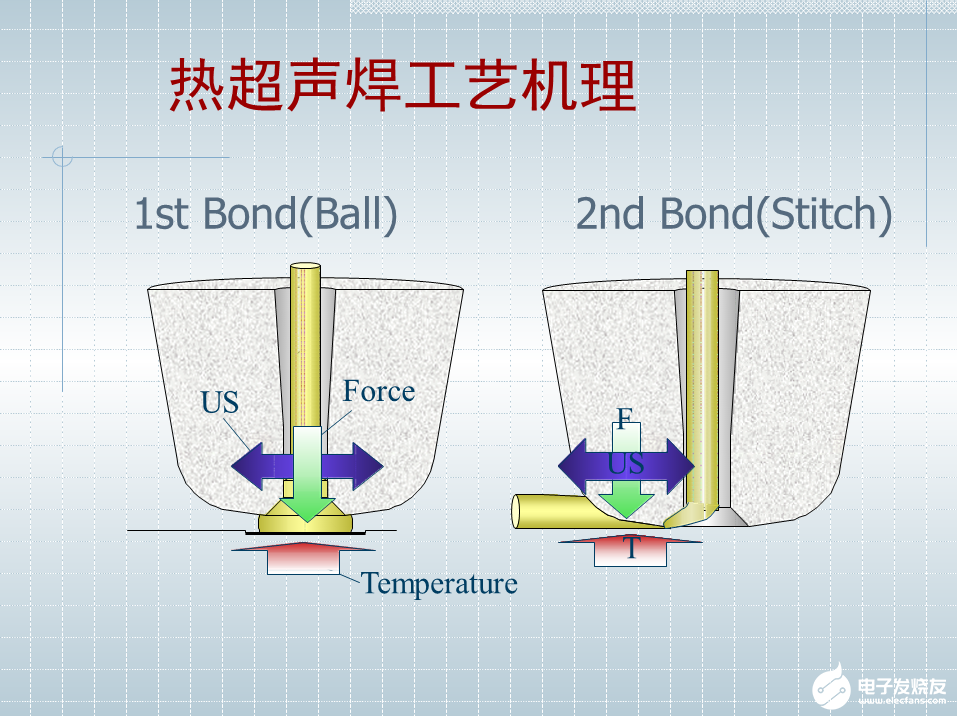






















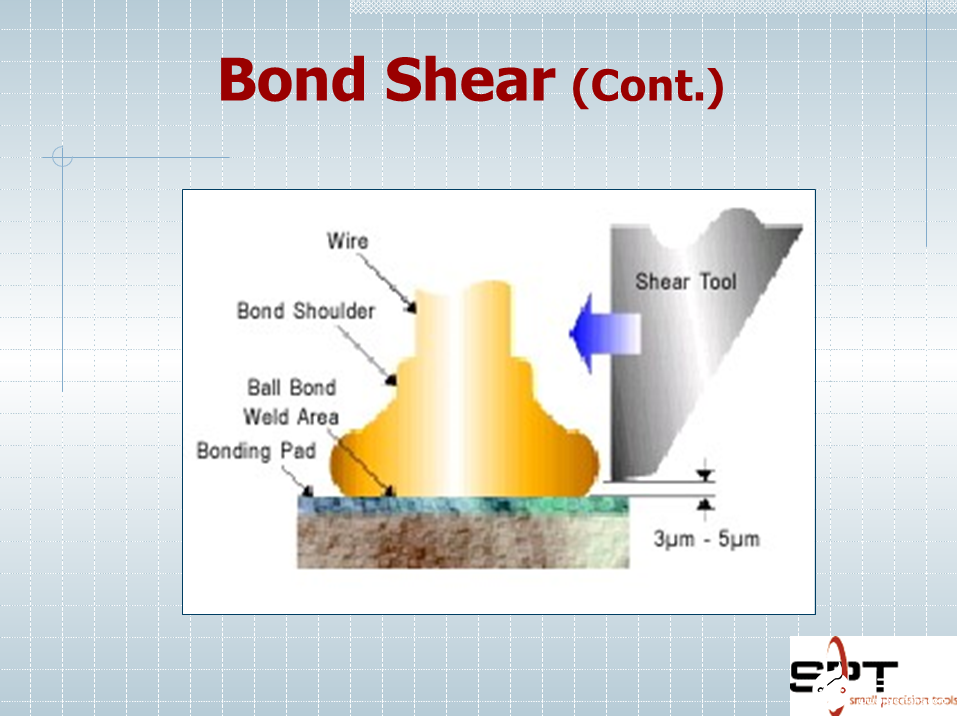

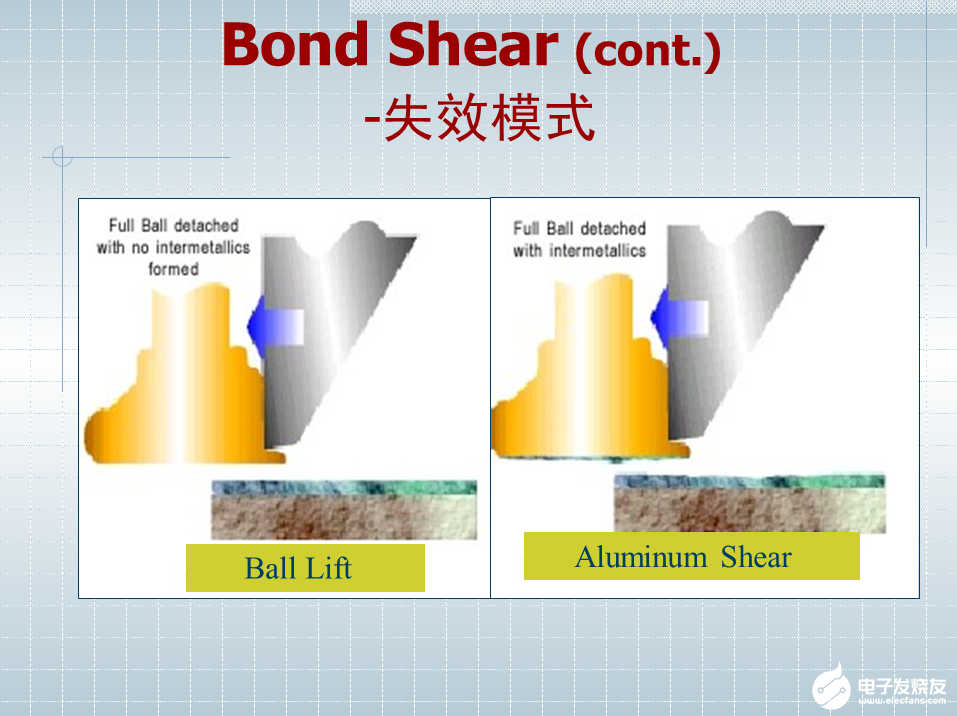
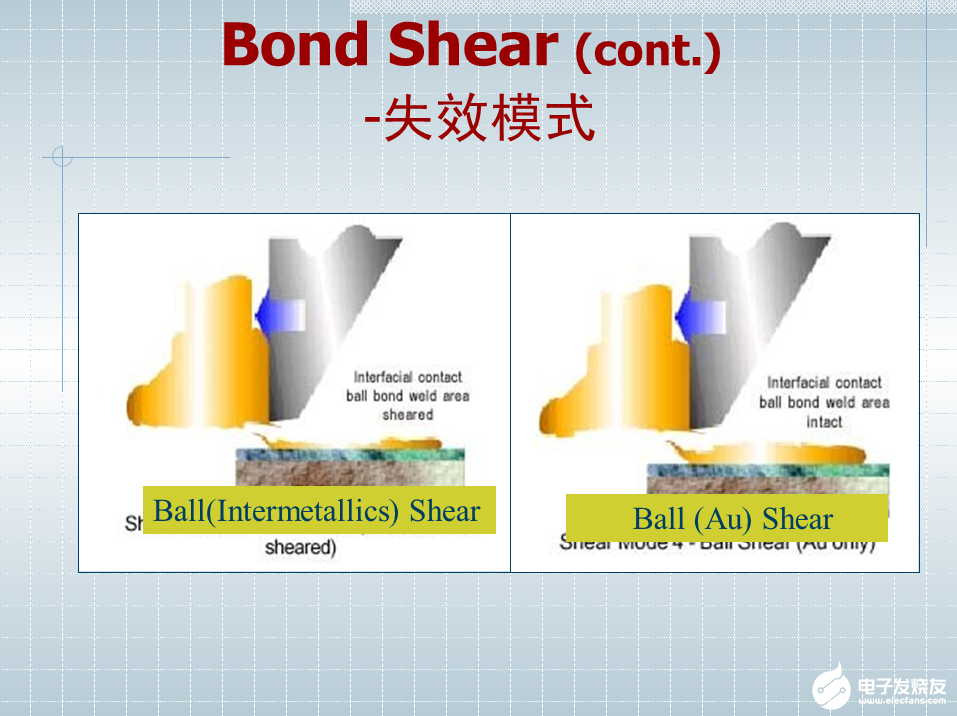
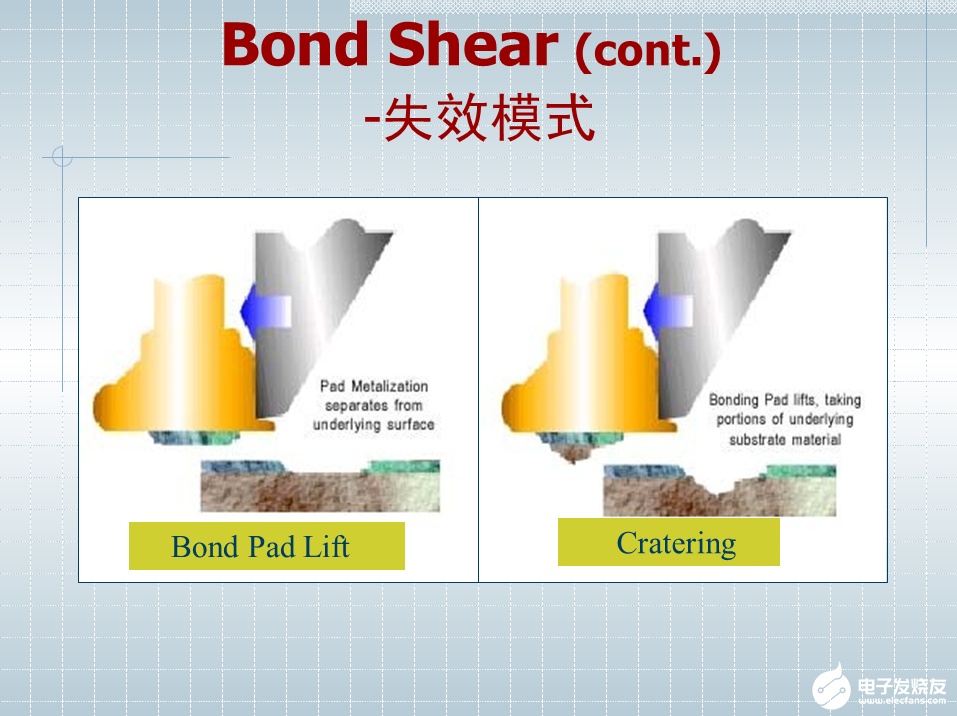





















-
封裝
+關(guān)注
關(guān)注
128文章
9014瀏覽量
147374 -
鍵合
+關(guān)注
關(guān)注
0文章
86瀏覽量
8215
發(fā)布評(píng)論請(qǐng)先 登錄
有償求助本科畢業(yè)設(shè)計(jì)指導(dǎo)|引線鍵合|封裝工藝
MEMS工藝中的鍵合技術(shù)
成本更低但鍵合性能相當(dāng)甚至更好的銅線來(lái)代替金線鍵合
集成電路銅線鍵合工藝技術(shù)詳解
集成電路封裝基板工藝詳解(68頁(yè)PPT)
晶圓鍵合工藝技術(shù)詳解(69頁(yè)PPT)
集成電路封裝基板工藝詳解(68頁(yè)PPT)
半導(dǎo)體封裝技術(shù)基礎(chǔ)詳解(131頁(yè)PPT)
氧濃度監(jiān)控在熱壓鍵合(TCB)工藝過(guò)程中的重要性






 金線鍵合工藝技術(shù)詳解(69頁(yè)P(yáng)PT)
金線鍵合工藝技術(shù)詳解(69頁(yè)P(yáng)PT)
















評(píng)論