三維集成電路與晶圓級(jí)3D集成介紹
微電子技術(shù)的演進(jìn)始終圍繞微型化、高效性、集成度與低成本四大核心驅(qū)動(dòng)力展開,封裝技術(shù)亦隨之從傳統(tǒng)TSO....
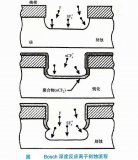
CMOS集成電路中閂鎖效應(yīng)的產(chǎn)生與防護(hù)
閂鎖效應(yīng)(Latch-up)是CMOS集成電路中一種危險(xiǎn)的寄生效應(yīng),可能導(dǎo)致芯片瞬間失效甚至永久燒毀....
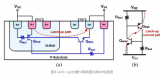
淺談三維集成封裝技術(shù)的演進(jìn)
在半導(dǎo)體封裝領(lǐng)域,堆疊技術(shù)作為推動(dòng)高集成度與小型化的核心趨勢,正通過垂直堆疊芯片或封裝實(shí)現(xiàn)更緊湊的封....

功率半導(dǎo)體晶圓級(jí)封裝的發(fā)展趨勢
在功率半導(dǎo)體封裝領(lǐng)域,晶圓級(jí)芯片規(guī)模封裝技術(shù)正引領(lǐng)著分立功率器件向更高集成度、更低損耗及更優(yōu)熱性能方....

淺談SPICE模型參數(shù)自動(dòng)化提取
在過去的幾十年里,半導(dǎo)體器件緊湊型模型已經(jīng)從 BJT Gummel-Poon 模型中的幾個(gè)參數(shù)發(fā)展到....
詳解芯片制造中的可測性設(shè)計(jì)
然而,隨著納米技術(shù)的出現(xiàn),芯片制造過程越來越復(fù)雜,晶體管密度增加,導(dǎo)致導(dǎo)線短路或斷路的概率增大,芯片....

硅通孔電鍍材料在先進(jìn)封裝中的應(yīng)用
硅通孔(TSV)技術(shù)借助硅晶圓內(nèi)部的垂直金屬通孔,達(dá)成芯片間的直接電互連。相較于傳統(tǒng)引線鍵合等互連方....

系統(tǒng)級(jí)立體封裝技術(shù)的發(fā)展與應(yīng)用
系統(tǒng)級(jí)立體封裝技術(shù)作為后摩爾時(shí)代集成電路產(chǎn)業(yè)的核心突破方向,正以三維集成理念重構(gòu)電子系統(tǒng)的構(gòu)建邏輯。

晶體管的基本結(jié)構(gòu)和發(fā)展歷程
隨著集成電路科學(xué)與工程的持續(xù)發(fā)展,當(dāng)前集成電路已涵蓋二極管、晶體管、非易失性存儲(chǔ)器件、功率器件、光子....
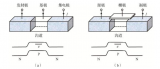
集成電路制造中封裝失效的機(jī)理和分類
隨著封裝技術(shù)向小型化、薄型化、輕量化演進(jìn),封裝缺陷對可靠性的影響愈發(fā)凸顯,為提升封裝質(zhì)量需深入探究失....

集成電路中場效應(yīng)晶體管的寄生參數(shù)提取方法
柵極電阻的存在對電路性能的影響很大,會(huì)引入熱噪聲,增大電路的噪聲系數(shù),影響器件的開關(guān)速度和最大振蕩頻....
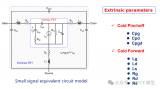
HBM技術(shù)在CowoS封裝中的應(yīng)用
HBM通過使用3D堆疊技術(shù),將多個(gè)DRAM(動(dòng)態(tài)隨機(jī)存取存儲(chǔ)器)芯片堆疊在一起,并通過硅通孔(TSV....
一文詳解BSIM-SOI模型
隨著半導(dǎo)體工藝進(jìn)入納米尺度,傳統(tǒng)體硅(Bulk CMOS)技術(shù)面臨寄生電容大、閂鎖效應(yīng)等瓶頸。SOI....
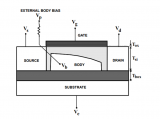
電源管理芯片常見術(shù)語
PMIC (Power Management Integrated Circuit):電源管理集成電....
一文詳解TEM中的非彈性散射和電子束損傷
為什么非彈性散射值得我們關(guān)注?因?yàn)檫@類散射過程產(chǎn)生了多種信號(hào),每種信號(hào)都能提供比彈性電子更豐富的樣品....